工具/软件:
尊敬的团队:
我们 在我的电路板中使用了电源模块 IC TPSM846C23MOLR。 我们遵循了上述 IC 数据表中提供的模板设计

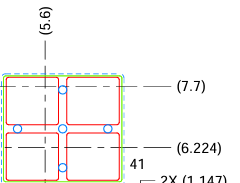
在组装过程中、组装元件后、IC 的角附近会出现小焊球。 在我们的几乎所有电路板中、我们都面向 IC 附近的相同焊球。
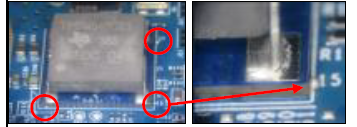
请提供有关如何缓解这一问题的建议。 请提供任何更新的模板布局建议以避免该问题。
此致、
Abhishek
This thread has been locked.
If you have a related question, please click the "Ask a related question" button in the top right corner. The newly created question will be automatically linked to this question.
工具/软件:
尊敬的团队:
我们 在我的电路板中使用了电源模块 IC TPSM846C23MOLR。 我们遵循了上述 IC 数据表中提供的模板设计

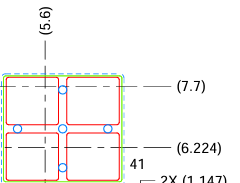
在组装过程中、组装元件后、IC 的角附近会出现小焊球。 在我们的几乎所有电路板中、我们都面向 IC 附近的相同焊球。
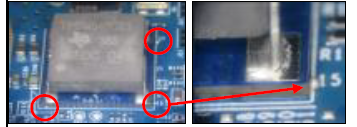
请提供有关如何缓解这一问题的建议。 请提供任何更新的模板布局建议以避免该问题。
此致、
Abhishek
尊敬的 Abhishek:
是的、我可以帮助澄清。 您看到的焊球可能是由多种原因引起的。 您可以让合同制造商减少您看到的角的模板孔径/开口、根据您之前的消息、它看起来像角中的销、因此引脚 1、15、27、41。 当前模板的尺寸为 100%、因为这是原始模板、您可以检查是否可以将这些引脚的模板尺寸减小到 90%左右、从而使它们更小。 您也可以让他们对 IC 施加更小的压力、或使用更少的粘贴量、这也会有所帮助。
我还建议确保回流焊遵循数据表“Level-3-260C-168 HR“末尾的 MSL 等级/峰值回流焊、这本质上意味着该器件具有 3 级湿敏等级、因此一旦封装打开、器件就可以吸收空气中的水分;器件必须在 168 小时内回流焊、因为封装已打开并暴露在空气中、否则您必须烘烤它。 最高温度为 260C、该器件的额定用于回流焊接工艺、符合 JEDEC 标准。