关于低压降稳压器(LDO)、一个常被误解的主题是热耗散。 LDO 使用 FET 降低输入电压以实现所需的输出轨。 该功率在励磁反应中在 LDO 和能量释放过程中耗散。 压差越大、热耗散越大。 为了减少与散热相关的问题,选择正确的部件和封装非常重要(有关选择正确封装的更多信息,请参阅 LDO 基础知识 )。 选择器件后、仍然有多种改善散热的方法。 良好的电路板布局布线可以将 θJA R θ JEDEC 的热耗散降低30-50%。 同样、糟糕的布局会显著降低 IC 的散热能力。 良好的电路板实践包括:尽可能在热 IC 元件周围添加额外的金属和散热过孔。 有关电路板的其他改进、请参阅 电路板布局对 LDO 热性能影响的经验分析。 下面我们将讨论有关热性能的常见问题。
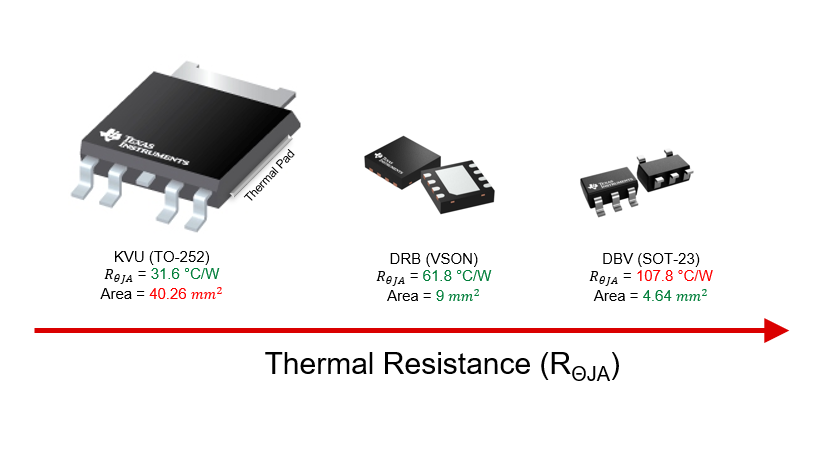
图1:KVU、DRB 和 DBV 封装的尺寸和热效率。 热阻值指定了每耗散1瓦功率、IC 结温将升高多少摄氏度。 一般来说、封装尺寸越大、散热性能越好(尤其是具有散热焊盘时)。
下面探讨的常见问题:
1) 1)如何在德州仪器数据表中计算热指标?
2)θJA 定义的热指标 R_k Ω、T_J 和 T_A。
3) 3)数据表中提供的热指标有何差异?它们的实际用途是什么?
4) 4)不同电路板的热指标有多大差异?
5) 5)在比较不同指标时、为什么同一封装中的不同器件具有不同的热性能值? 同样、当 θJC 两个不同的封装时、为什么一个封装的 R_Θ θJA 更好、但 R_(Δ t (top))值更差?
6) 6)如何在实验室中测试热性能?
7) 7)如何计算器件的温度?
8) 8)比较不同器件的热性能的最佳指标是什么?
9) 9)如何比较 TI 器件和非 TI 器件的热性能规格?
下面提供了其他资源和参考。
常见问题:
1) 1)如何在德州仪器数据表中计算热指标?
德州仪器(TI)产品说明书使用基于 JEDEC 高 K 标准电路板布局(由 JESD51-7定义)的热仿真和模型来计算指标。 这些仿真通过严格的实际测量进行了验证、从而验证了建模参数之间的相关性。 有关 JEDEC 板的更多信息、请参阅 半导体和 IC 封装热指标。有关不同电路板设计和 JEDEC 标准之间的比较、请参阅 电路板布局对 LDO 热性能影响的经验分析。

图2:JEDEC 标准2s2p PCB。
图像源自 TPS7B86-Q1数据表。
2)θJA 定义的热指标 R_k Ω、T_J 和 T_A。
R_θ θJA 的定义是 IC 结温(T_J)相对于环境温度(T_A)每1W 功耗升高多少摄氏度。 例如、61.8 °C/W 的 R_Θ θJA 值意味着在耗散的每瓦功率下 IC 的温度将比环境温度高61.8度。
3) 3)数据表中提供的热指标有何差异?它们的实际用途是什么?
图3:热指标关键术语图、在每一个下面对其进行了解释并说明了相应的热指标。
表1:热指标说明
通常、与 θ 指标相比、psi 电路板测量往往提供了更准确的近似值。 这是因为 JEDEC 标准中的 psi 值不假设热性能来自一个位置、而是来自包括 IC 和电路板在内的多个位置。
计算结温的最佳方法是使用以下公式。

这增加了复杂性、因为在对电路板进行布局、选择器件并制造 PCB 之前、通常不知道 T_PCB。 这是 R_Θ θJA 值仍常用于在设计阶段估算结温的关键原因之一。 在了解电路板温度之前、设计人员通常知道空气的环境温度、并可将其用于计算 IC 的结温。
请注意、这个近似值受到 PCB 电路板布局布线的严重影响。 有关 R_R θ θJA 将如何受到 PCB 布局影响的更多信息、请参阅问题4。
有关这些指标和详细信息的更多信息、请参阅 半导体和 IC 封装热指标。
4) 4)热指标会因电路板设计而异的程度如何?
结果表明、与 JEDEC High-K 电路板标准相比、电路板设计能够将热性能提高大约30-50%。 通过对电路板布局对 LDO 热性能影响的经验分析 、可以深入比较五种独特布局中三种不同封装的 R_Θ θJA。 θJA 总结一个电路板差异示例、报告中的图7 (如下所示)显示了使用 TPS745 (WSON)器件2x2封装的不同电路板设计的比较、该封装的 JEDEC 标准仿真值为 R_BIN= 80.3°C/W。 从图中可以看出、使用热饱和电路板可将性能提高46%、使用热增强型电路板可将性能提高42%(请参阅应用手册、了解有关这些布局差异的更多信息)。 然而、对于散热效率低的单层电路板(1S0P)、热性能会显著下降、增加了210%。 这就强调了使用良好布局实践以及尽可能在热元件周围添加金属和散热过孔的重要性。 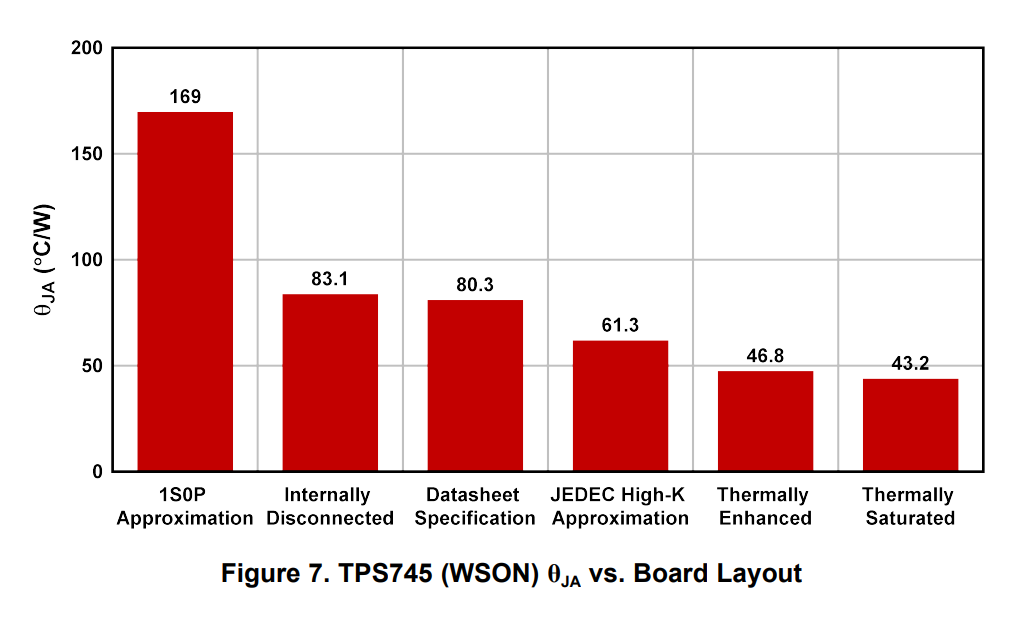
中的图和数据来源: 电路板布局对 LDO 热性能影响的经验分析。
5) a)为什么同一封装中的不同器件在比较不同指标时具有不同的热性能值? b)θJA、当比较两个不同的封装时、为什么一个的 R_Θ θJC 更好、但 R_(Δ f (top))值更差?
a)查看不同的封装时、器件可以具有改进的散热焊盘设计、但在芯片顶部和封装顶部之间需要更多的模压化合物。 这可能会 θJA 较低的 R_k Ω 和较高的 R_(θJC Ω(top))(回想一下、R_(θJC Ω(top))热阻假设所有热量都通过外壳顶部传递、这是一个不良的假设)。
B) R_n ü θJA 和 R_(θJC (top))值在很大程度上取决于模塑化合物中的芯片尺寸、封装的散热焊盘和芯片的垂直度(z 位置)。 散热的最有效路径通常是散热焊盘、它是焊接到 PCB 的封装底部的金属块。 散热焊盘使裸片的整个表面积能够更有效地将热量传导到 PCB、从而降低结温和 R_Θ θJA。
6) 6)如何在实验室中测试热性能?
可以使用结温与功率耗散之间的线性关系在实验室中测试热性能。 随着功率耗散上升、芯片的结温也以线性方式上升。 通过使用这种现象、您可以测量特定电路板的 R_Θ θJA。 为了测量准确的 T_A (环境温度)、可以使用 Thermostream 或烤箱来设置和测量 LDO 周围的空气温度。 对于高精度测量、请在箱内使用完全绝缘的加热室和温度探针、将 R_k Ω θJA 定义为仅使用自然对流(无强制空气)。 在 θJA 公式中有两个未知值:T_J (结温)和 R_θ J。
需要两个公式来求解未知数。 需要操控 T_A 和 P_Absense 来使器件进入热关断状态、这种情况发生在测试单元的可重复温度下。 应该为 T_A 选择一个相对较高的值、然后可以增加 P_DISA散、直到器件进入热关断状态。 需要在 LDO 进入热关断时记录数据点以获得准确的测量结果。 在更改 T_A 或 P_Absense 后、等待几分钟、然后继续进入下一个测量点、以使器件和 PCB 温度趋于稳定。 请记住、某些测试设备可能会在高温下停止工作、因此应进行相应选择。 以下过程用于测试 TO-252封装。 测试条件将因封装而显著变化、以便加快测量测试条件的选择应接近估算的热关断值。
公式1: 使用计算结温


图4:结温与功率耗散之间线性关系的可视化表示。
例如:
测量1: 将加热室设置为125°C。 使用具有300mA 负载的5V 输出 LDO、以20V 的电压启动 Vin (输入电压)(该值由用户选择)、然后非常缓慢地增加电压、直到器件进入热关断状态(器件将关闭) 输出电压固定为12V 的器件。 测量了 Iout、等于0.293A。 一旦器件进入热关断状态、则记录器件的输入电压。
Vin = 25.02V、Vout = 5.0V、Iout = 0.293A、Temp = 125°C–启动电压为23.0V、增加0.02、直到器件在25.02V 时进入热关断状态。
然后、这些值被用来创建以下等式:
测量2: VIN = 15.80V、Vout = 5V、Iout = 0.283A、Temp = 150°C–在12.0V 时启动电压、并增加0.02、直到器件在15.08V 时进入热关断状态。
我们可以将这些公式设置为彼此相等、因为热关断发生在相同的结温下:
有关计算的其他帮助和资源、请参阅 视频培训:测量热性能-您的 LDO 有多热?
7) 7)如何计算器件的温度?
以下是在已知环境温度(TA)的情况下计算结温(TJ)所需的公式。 请注意、I_ground 可在 TI 数据表中找到、但对于高于1mA 的负载电流、接地电流(Iground)引起的附加功率耗散将足够小、可能被忽略。 θJA 使用上述计算结果或进行初始估算、可以使用数据表编号。
8) 8)比较不同器件的热性能的最佳指标是什么?
A:在两个带有散热焊盘的器件之间做出决定时、比较的最佳指标是
R_(θJC Ω(底部))或结至外壳(底部)热阻。 通常、LDO 中的大部分热量都通过底部散热区散发、因此 R_(θJC (底部))是比较两个不同器件的最佳指标、因为它消除了制造商在提供其他热指标时可能作出的任何 PCB 板假设。 对于没有散热焊盘的器件、ψ_JB 是最佳的比较指标、因为大多数热量仍然通过引脚传递到 PCB。
9) 9)如何比较 TI 器件和非 TI 器件的热性能规格?
答:使用上述问题8中说明的指标。 此外、务必对照两种不同品牌的器件检查和比较热测试条件。 如果测试条件模糊或没有提供关于它们是如何获得的很多信息、我们不能假定它们使用 JEDEC 标准板进行仿真。 此外、检查其电路板是否符合标准 JEDEC 规范、并确保设计中没有额外增加铜、额外层等。 如果两家公司都使用相同的电路板假设、则指标会提供直接比较。 如果 PCB 假设不相同、则不能直接比较这些值、而应在同一电路板上进行测试;这是电路板布局布线会对热性能产生很大影响的原因。
其他资源和参考资料:
视频培训 LDO 热基础知识–LDO 热基础知识视频版本
LDO 基础知识 –LDO 的基本解释和一些常见问题和主题的概述
电路板布局对 LDO 热性能影响的经验分析 –五种不同电路板布局和设计之间的深入热比较
半导体和 IC 封装热指标 –深入介绍 JEDEC 标准热指标
采用小型 SMD 封装的 LDO 热性能 –比较连续负载和脉冲负载条件
视频培训:测量热性能-您的 LDO 有多热? –有关如何测量 IC 热性能的视频指南、并讨论了上面提到的热公式和方法。
