主题中讨论的其他器件: LM5069
全部为高电平。
下图显示了 CSD19533Q5A 数据表中提供的热阻数据及其实现条件。 如果我使用相同的薄片 FR4、铜箔厚度2oz、PCB 尺寸为1英寸2、并在 PCB 的顶层和底层之间添加上孔。 然后在 PCB 背面添加热传导硅胶垫和散热器、再如何估算热阻 RthPCB 的值? 谢谢你。


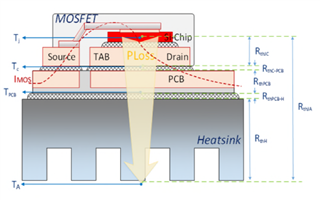
This thread has been locked.
If you have a related question, please click the "Ask a related question" button in the top right corner. The newly created question will be automatically linked to this question.
全部为高电平。
下图显示了 CSD19533Q5A 数据表中提供的热阻数据及其实现条件。 如果我使用相同的薄片 FR4、铜箔厚度2oz、PCB 尺寸为1英寸2、并在 PCB 的顶层和底层之间添加上孔。 然后在 PCB 背面添加热传导硅胶垫和散热器、再如何估算热阻 RthPCB 的值? 谢谢你。


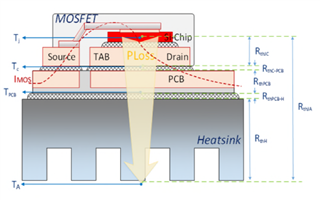
尊敬的盛阳:
再次感谢您关注 TI FET。 估算 PCB 热阻的最佳方法是使用 ICE PAK 或 Flotherm (有许多其他工具可供使用)等工具进行热仿真。 Boyd 等一些散热器供应商也提供在线工具。 您还可以估算此值、如下面链接中的应用手册所示。
https://www.ti.com/lit/an/slpa015/slpa015.pdf
此致、
约翰·华莱士
TI FET 应用
大家好。 约翰·华莱士
如下面的图1所示、红框中概述的热规则说明、在功率器件下方产生热量的焊盘上添加10个以上的散热过孔可以获得10⁰C μ V/W 的热阻。 如图2所示、对于一个四层电路板、2oz 厚的铜、每层有铜箔的裸露铜区域重叠、有20个散热过孔、这种情况不是 PCB 的热阻可视为10⁰C Ω/W?

图1

图 2
已查阅技术手册(准确的热计算在餐巾背面)。 手册中几个示例的铜箔面积计算似乎是任意的、我找不到相应的模式。 例如、不清楚如何选择下面图3中红色框的区域? 为什么选择底部铜箔的整个长度面积为2.3in 而不是3.9in?
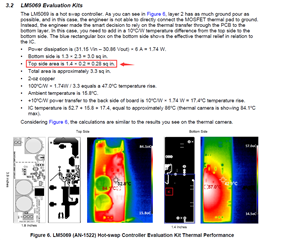
图 3
您是如何获得如下面的图4所示的0.5平方英寸的顶端面积的? 后者除以3.8是否等于输入误差? 我想它应该是3.3。
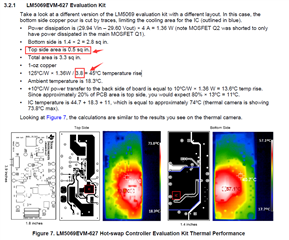
图 4
您好!
散热过孔的想法是、它们不是必需的、因为 PCB 板中的各层之间存在如此良好的热连接。 第3.2节中包含 LM5069套件的示例展示了这一点。 电路板背面没有散热过孔、热量会立即流动。 从顶部到底部有一个大约10oC/W 的热阻抗用于冷却。 这就是为什么热点顶部温度为~ 84oC、底部温度为57oC 的原因。
关于 LM5069示例中要使用的铜的尺寸问题、第3.2节: 此处的想法是电路板上的过孔和其他布线会有效减小我们的有效表面积以进行散热。 从底部的热像仪图像可以看到、没有太多热量"向上"流经这些过孔(以蓝色显示)。 因此、我们的有效底部表面面积大约仅为电路板尺寸的60%。 顶部几乎没有铜来散热。
最后一个问题是我如何计算0.5平方英寸的顶面面积、如下面的图7 (E2E 博文中的图4)所示。 是的、3.8应该 是3.3。 拉出 EVM 后、我已将表面面积重新计算为大约3.55平方英寸。 因此、公式应为125oC/W x 1.36W / 3.55 sq in = 48oC 温升。 (附图)

此致、Keith