Other Parts Discussed in Thread: LM317M
工具与软件:
嗨、团队:
我找不到该器件允许的最大损耗与温度之间的关系。
是否有这些信息?
此致、
柳。
This thread has been locked.
If you have a related question, please click the "Ask a related question" button in the top right corner. The newly created question will be automatically linked to this question.
你好 Ryu、
第6.3节说明了最高结温。 最大内部功耗取决于所使用的封装和电路板布局、您通常可以在数据表第6.4节的热性能信息表中找到此信息。 我们的热指标是使用 JESD51-7中指定的 JEDEC High-k 电路板布局来模拟的;该电路板未进行热 性能优化、但作为标准化参考布局来轻松比较热性能。 我不知道为什么只有 DCY (SOT-223)封装的热性能数据;如果您需要其他器件、我可以提交要求对其进行仿真。
这里有几个关于该主题的应用手册。
电路板布局布线对 LDO 热性能影响的经验分析:https://www.ti.com/lit/an/slvae85/slvae85.pdf
《半导体和 IC 封装热指标》:https://www.ti.com/lit/an/spra953c/spra953c.pdf
此致、
Nick
你好 Ryu、
是的、我的回复是指更复杂的热性能问题、我不能告诉您最大功率耗散、因为有许多变量会影响器件可以处理的功率耗散(尤其是电路板布局布线、器件封装和环境温度是主要的影响因素)。 一般而言、对于 LM317M 等器件、它看起来与下图类似、这些器件具有高潜在功率损耗(VIN - VOUT 最大值为37V、额定负载电流为0.5A)、但斜率很大程度上受电路板布局布线和封装热指标的影响。 您是否知道应用的最高环境温度、最大负载电流以及您对哪种封装感兴趣?
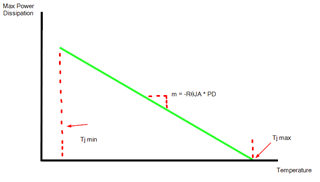
此致、
Nick